Engadgetによると、Intel は新しいガラス基板は既存の有機材料よりも耐久性と効率性に優れていると述べている。このガラスにより、同社は複数のチップレットやその他のコンポーネントを並べて配置することも可能になる。これにより、有機材料を使用した既存のシリコン パッケージと比較して、曲がりや不安定性に関して同社に課題が生じる可能性があります。
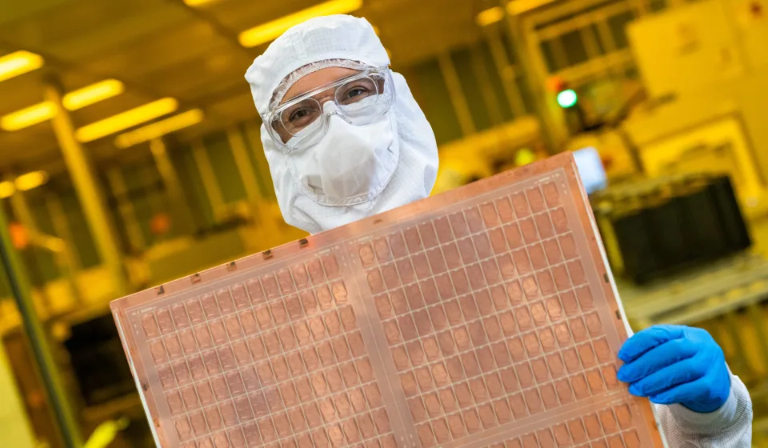
インテル、基板製造技術の飛躍的進歩を披露
インテルはプレスリリースで、「このガラス基板は高温に耐え、パターン歪みが50パーセント少なく、極めて低い平坦性でリソグラフィーの焦点深度を改善し、また極めて緊密な層間結合に必要な寸法安定性も提供する」と述べた。
同社は、これらの機能により、ガラス基板は相互接続密度を10倍に高めるとともに、「組み立て歩留まりの高い超大型パッケージ」の作成も可能にすると主張している。
Intel が将来のチップの設計に多額の投資を行っていることは知られています。同社は2年前、「ゲート・オールアラウンド」トランジスタ設計のRibbonFETと、チップのウェハの裏側に電力を移動できるPowerViaを発表した。インテルはまた、クアルコムとアマゾンのAWSサービス向けのチップを製造することも発表した。
インテルは、ガラス基板を使用したチップは、まずAI(人工知能)、グラフィックス、データセンターなどの高性能分野で使われるだろうと付け加えた。このガラスの躍進は、インテルが米国のファウンドリーで先進的なパッケージング能力も強化していることを示すもうひとつの兆候だ。
[広告2]
ソースリンク





![[写真] ト・ラム事務総長が決議第18-NQ/TW号の実施状況を検討する第3回会議を主宰](https://vstatic.vietnam.vn/vietnam/resource/IMAGE/2025/4/14/10f646e55e8e4f3b8c9ae2e35705481d)























































































コメント (0)